二手 ESEC 3088iP #9091720 待售
網址複製成功!
單擊可縮放
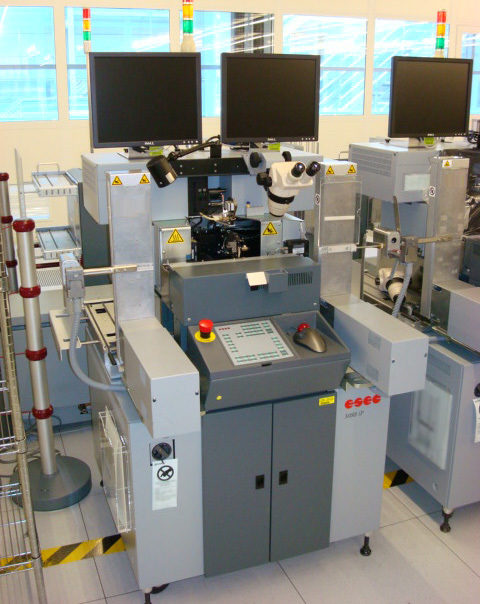

ID: 9091720
優質的: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP是一種工業半導體封裝機,旨在在半導體芯片的各個引腳與其引線之間形成緊密的電氣連接。該機采用先進的楔桿接合技術,實現精密半導體封裝的高通量制造。ESEC 3088I P封裝由觸摸屏數字界面、超聲波粘合器頭、對準系統、參數控制單元、粘結數據控制單元等幾個主要組件組成。數字界面允許簡單直觀的機器控制以及工藝參數的選擇和顯示。超聲波粘合器頭由雙軸系統組成,能夠處理各種包裝尺寸和鉛長度。對準系統由顯微鏡、CCD線掃描相機和平移微米頭組成。這種組件組合能夠測量印刷電路板與芯片導線之間的對準,以確保精確的鍵合位置。參數控制單元用於控制鍵合過程的頻率、功率、通量、楔力、電極葉片壓力、鍵合力等各種性質。債券數據控制單元用於存儲和監控債券數據,以保證質量和可追蹤性。3088 IP單元為自動化制造過程提供了快速、便捷的粘合解決方案。該機吞吐率高,可處理多芯片模塊(MCM)、四平無鉛封裝(QFN)、小輪廓集成電路(SOIC)、芯片規模封裝(CSP)等多種不同的半導體封裝。它還包括自動電源和溫度管理、高級通量控制、脈沖振蕩、多點力控制等先進功能。機器的整體設計大大降低了在粘合過程中損壞封裝或引線的風險。此外,機器產生的高質量結果可實現無錯誤操作,並使用戶對以最高精度和可靠性執行鍵合操作有一定程度的信心。
還沒有評論