二手 AMAT / APPLIED MATERIALS Centura MxP+ #166626 待售
看起來這件物品已經賣了。檢查下面的類似產品或與我們聯系,我們經驗豐富的團隊將為您找到它。
單擊可縮放
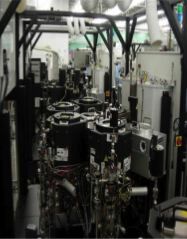

已售出
ID: 166626
晶圓大小: 8"
優質的: 1996
Oxide etch system, 8"
Install Type: Stand-Alone
Cassette Interface:
(Qty 2) Jenoptic InFab (SLR-200-LPTSL/R) Bolt-On SMIF
Wafer Shape: SNNF (Notch)
Centura (common) M/F:
Robot: HP
Robot Blade Type: Ceramic
Wafer on Blade Detect
Umbilicals :
Cntrl - M/F: 40ft
Pump - M/F Intfc: 50ft
RF PS - Chamber: 50ft
Water Leak/Smoke Detection
Facility Connections: M/F Rear
M/F Exhaust Line: 304SST
Status Lamp (RYG)
System AC / Controller:
Type: Phase 1
System SW: Legacy E3.8
Endpoint SW: ENDP28
GEMS / SECS Interface
GEMS SW ver.: OS2 E3.8
Load Locks:
Wide Body w/Auto-Rotation
25-Wafer Cassettes
Wafer Mapping
Chambers:
Position Chamber Type
E: Orienter (OA)
F: Orienter (OA)
A: MXP+ Oxide
B: MXP+ Oxide
C: MXP+ Oxide
D: MXP+ Oxide
Chamber E/F: Orienter (OA)
Lid Type: Hinged
Chamber A/B/C/D: MXP+
Lid Assy PN: 0010-36123 rev A
Lid Type: Screw/Bolt Down
Pedestal Type: Polyimide ESC
Process Kit: Quartz Single Ring
RF Match Type: Phase IV
Cathode Type: Simplified
Bias RF PS: ENI OEM-12B3
Endpoint Type: Monochromator
Throttling Valve + Gate Valve : Vat 65
Turbo Pump: Ebara ET300WS
Gas Box Config:
Vertical height: 31”
(Qty 10) Gas line positions per Pallet
Valve Type: Fujikin
Filter Type: Millipore
Transducer Type: SPAN
Controller Type: Standard
Facility Line Connection: Single Line Drop, Top Exhaust
Heat Exchanger / Chiller:
(Qty 2) Neslab 150
Fluid Type: 50 / 50
Power Requirements: V 208, 400A, 3-Phase, 4-Wire, 60Hz
1996 vintage.
AMAT/APPLIED MATERIALS Centura MxP+是設計用於納米加工過程的沈積反應器。它配備了強大的微波等離子體源,利用熱有機基化學氣相沈積(CVD)技術將分子薄膜沈積到基質上。MxP+的設計非常可靠,使用壽命長,非常適合關鍵生產過程。MxP+在真空室中操作。微波源提供能量,從反應氣體中產生等離子體,然後將其定向到底物上引起CVD。根據反應氣體的不同,可以沈積廣泛的材料,包括金屬、氧化物、氮化物和半導體。反應氣體的流動控制使材料的精確沈積具有精確的厚度控制。MxP+配備了柔性晶片臂,使直徑達六英寸的晶片能夠在腔內加載和移動。它是一個高度自動化的系統,具有用戶友好的界面,允許用戶創建和存儲流程。它可以在一定溫度、壓力和功率級別範圍內操作,因此用戶可以選擇最佳參數以獲得所需的結果。溫度被監測並保持在嚴格的公差範圍內,以確保準確的沈積速率。MxP+配備了多種安全功能來保護用戶和被加工的基板。腔室充滿低壓氣體,用於減少晶圓臂與腔壁之間的熱傳遞。這有助於防止對基板的熱損壞。該系統還包括一個自動劑量控制加功能,該功能調節微波源產生的等離子體數量,以保護腔壁,減少產品汙染的可能性。MxP+是研究和生產應用的理想選擇,提供精確度、可靠性和可重復性。它使用戶能夠開發新的沈積過程或優化現有的過程以提高性能。這種高性能的沈積反應器為先進的納米加工應用提供了理想的解決方案。
還沒有評論